常温溅射类金刚石DLC膜涂层的工艺研究
发布时间:2017-07-05
1、引言
DLC薄膜是碳的一种非晶亚稳态结构,在微观上它主要由一定比例的sp3键和sp2键混合组成。它具有类似于金刚石的优良的力学、机械和化学特性,同时是一种性能良好的红外材料,可用于红外探测、红外遥感及测温系统、红外窗口材料表面的增透保护膜。
磁控溅射是制备DLC膜的常用方法。采用磁控溅射法,在室温下开展其制备工艺的研究,对于这一新型薄膜材料应用于红外技术及光电技术有着重要的意义。沉积速率是表征成膜过程的物理量,是控制薄膜厚度、满足膜系设计要求的重要参数。研究工艺参数对沉积速率的影响规律不仅可以指导镀膜实践、实现多层膜的设计和制备,而且有助于理解磁控溅射的机理。本文研究了溅射功率、气体流量比、溅射频率、基底负偏压等工艺参数对DLC膜沉积速率的影响和薄膜的光学性能,为磁控溅射法沉积的DLC膜在红外系统上的应用奠定基础。
2、实验
实验设备采用脉冲磁控溅射镀膜系统,室温下在单晶Ge基片上沉积DLC薄膜。溅射靶材是高纯的石墨,原料气体是高纯氩气(99.995%)和一种碳氢气体。制备过程中选择的工艺参数范围为:溅射功率1000~3000W,气体流量比CH:Ar=0.075,~0.175,溅射频率5O~160kHz,基底负偏压10~100V。采用傅里叶变换红外光谱(FT-IR)对薄膜进行透射曲线的测量,并通过透过率曲线计算薄膜厚度。沉积速率R用所得薄膜的平均厚度d除以沉积时间t来计算。薄膜的具体工艺参数如表1所示。

3、结果与讨论
3.1 溅射功率对沉积速率的影响
实验研究发现溅射功率是影响沉积速率的一个最直接的因素。通过样品1#、2#、3#、4#的透过率曲线,计算薄膜的厚度。图1给出了样品1#、2#、3#、4#的沉积速率与溅射功率之间的关系曲线。

从图1中可以看出随着溅射功率的增加,沉积速率显著增大。这是因为溅射功率的大小会影响放电等离子体的强弱和溅射效率。溅射功率增大时,离子流与自偏压同时增大,离子流的增大导致参与溅射的离子数量增多,自偏压的增大使溅射原子的产额增加。因此,磁控溅射DLC薄膜中沉积速率随溅射功率的增大而增大。
3.2 碳氢气体与氩气流量比对沉积速率的影响
在磁控溅射过程中,气体流量比是非常重要的参数。图2是样品5#、4#、6#的沉积速率与气体(碳氢气体与氩气)流量比之间的关系曲线。

从图2中可以看出,随着碳氢气体与氩气流量比的增加,沉积速率增大,在流量比为0.125时沉积速率达到最大;随着碳氢气体与氩气流量比的继续增大,沉积速率降低。当碳氢气体与氩气流量比值很小时,反应溅射保持了同纯氩溅射相似的溅射产额和沉积速率;随着碳氢气体与氩气流量比值的增大,碳氢气体与碳靶反应,参与衬底上成膜,同时氩气提供溅射离子,使得沉积速率提高;当碳氢气体与氩气流量的比值过高时,碳氢气体除了与碳靶反应、参与衬底上成膜、被真空室吸附以及被抽气系统抽走之外,还有剩余。剩余的碳氢气体将在碳靶表面生成一层碳的化合物,使靶完全中毒,抑制了碳靶的溅射,导致沉积速率的下降。
3.3 溅射频率对沉积速率的影响
改变溅射频率,在其他的工艺参数相同的条件下得到沉积速率与溅射频率之间的关系。图3是样品4#、7#、8#的沉积速率与溅射频率之间的关系曲线。从图中可以看出沉积速率随溅射频率的减小而线性增大。当工作场强为定值时,频率越高,等离子体中正离子被加速的时间越短,正离子从外电场吸收的能量就越少,轰击靶的正离子能量也越低,靶的溅射速率也越低。

3.4 基底负偏压对沉积速率的影响
改变基底负偏压,在其他的工艺参数相同的条件下得到沉积速率与基底负偏压之间的关系。图4为样品4#、9#、1O#、11#所得沉积速率与基底负偏压之间的关系曲线。
从图中可以看出:当负偏压由1OV增大到80V时,沉积速率逐渐增大;当负偏压由80V增大到100V时,沉积速率有所下降。这是因为当衬底上加适当负偏压时,可以有效的提高沉积粒子与衬底结合、相互之间形成薄膜时的结合力以及薄膜致密性。实验发现80V是最好的基底负偏压。
通过上述研究,得到获得最佳的工艺参数为:溅射功率3000W,碳氢气体与氩气流量比0.125,溅射频率5OkHZ,基底负偏压80V。通过傅里叶变换红外光谱(FT-IR)对此样品进行透过率曲线的测量。测量结果如图5所示。

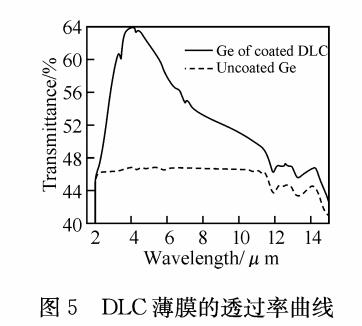
从图5中可以看出,常温下,采用磁控溅射技术在Ge基底单面上制备DLC膜的透过率达到63.99%(4.03um),与理论值十分接近(如果将Ge的折射率按4.0计算,理论峰值透过率是64%)
4、结论
本文在常温下,采用磁控溅射技术成功地在Ge基底上制备了DLC膜,得出以下结论:
1)磁控溅射DLC薄膜中沉积速率随溅射功率的增大而增大,随溅射频率的减小而增大;随碳氢气体与氩气流量比、基底负偏压的增大先增大后降低,出现极大值。
2)获得最佳的工艺参数:溅射功率3000W,碳氢气体与氩气流量比0.125,溅射频率5OkHz,基底负偏压80V。
3)Ge基底上单面制备DLC膜的透过率达到63.99%(4.03um),与理论值十分接近红外光学系统的需求。
声明:本站部分图片、文章来源于网络,版权归原作者所有,如有侵权,请点击这里联系本站删除。
| 返回列表 | 分享给朋友: |
- 上一篇:DLC类金刚石薄膜涂层及其研究进展
- 下一篇:三种中频对靶磁控溅射类金刚石膜的性能…








 京公网安备 11010502053715号
京公网安备 11010502053715号