沉积工艺参数对AlN薄膜择优取向影响的实验研究
发布时间:2022-01-18
多年前,具有低的插入损耗与高的带外抑制的小型化高频率器件成为研究热点,尤其在高频移动通信领域。声表面波(SAW)器件有着优良的特性在高频通信领域有着广阔的应用前景。在制作高频声表面波(SAW)器件时,应用具有高声速的材料成为解决问题的关键。
从材料角度考虑,存在两种主要方式来提高器件工作频率。第一种为选择高声速的单晶压电材料,如铌酸锂,氮化铝等。第二种方式则是在高声速衬底上生长压电材料的多层膜设计,包括ZnO/sapphire,AlN/sapphire已经被研究,其中ZnO/sapphire结构声速为6000m/s,这为ZnO结构声表面波滤波器的2倍。由于金刚石具有所有物质中最高的弹性摸量(E=1200GPa),较低的材料密度(P=3.51g/cm3),从而声速在所有物质中最高。压电材料AlN属六方晶系,6mm点群,无对称中心,具有较高的机电耦合系数、低的传输损耗以及良好的热稳定性,同时,AlN薄膜的声表面波速度是所有无机非铁电性压电材料中最高的。同时,其温度系数接近于零。所以AlN/diamond基片是GHz频段声表面波(SAW)器件的首选材料之一。
一般来说,AIN薄膜在压电器件中的应用多以C轴的(002)面为主,对于AlN/diamond基片上的AlN薄膜要求其结构必须具有多晶择优取向,组成均匀,表面粗糙度小。在金刚石片上制备(002)面择优取向的A1N薄膜的研究是有重要意义的。
本文采用磁控溅射的方法,在金刚石(111)片上制备了(002)面择优取向的AlN薄膜。用x射线衍射的方法研究了氩气氮气比例、溅射气压等工艺参数对薄膜晶面取向的影响。
1、实验
本文采用超高真空射频磁控溅射反应系统进行薄膜沉积。实验中选用铝靶材的纯度为99.999%。靶到基片的距离为65mm。工作气体Ar和反应气体N2纯度均为99.999%。溅射前真空室的本底真空优于5X10-5Pa。实验之前首先按标准的集成电路清洗工艺处理基片,然后将基片放入进样室进行原位清洗。沉积前先将挡板挡上基片,充人Ar气,将Al靶材先预溅射15min,以除去靶面的AI2O3层,再关闭Ar气,通人N2气,预溅射10min,待靶的电流和电压充分稳定后再打开挡板,露出基片,以保证薄膜初始沉积就有良好的取向。
薄膜的结晶取向采用日本理学公司的D/MAXⅢ一c型x射线衍射仪(Cu靶,λ=0.15418nm,40kV,150mA)来分析。
2、结果与讨论
2.1 硅衬底上氮化铝薄膜x射线衍射结果分析
本实验在其他工艺条件不变的情况下对不同氩氮比(14:6、10:10、8:12、4:16)对氮化铝薄膜的取向的影响进行了研究,并进行了XRD测试分析。
图1为溅射功率为75w,衬底加热温度为300℃时,在硅衬底上生长AlN薄膜的图谱,研究了AlN薄膜的晶面择优取向状况与溅射气体氩气与氮气比例P的关系图。当P为14:6时,AlN薄膜的XRD图谱图1(a)上出现(100)面衍射峰,此时2θ=33.2℃;当氮气比例调高到P=10:10时,(100)面衍射峰变化不明显如图1(b),当氮气比例进一步增加为P=8:12时,薄膜的XRD图谱图1(c)中的(100)面衍射峰消失,出现了(002)面衍射峰,此时2θ=36.0℃,当氮气流量继续增大时,薄膜仍以(002)面择优取向,衍射峰强度逐渐增大。可以看出,随着氮气氩气比例增大有利于(002)面择优取向,随着氮气氩气比例减小有利于(100)面择优取向。
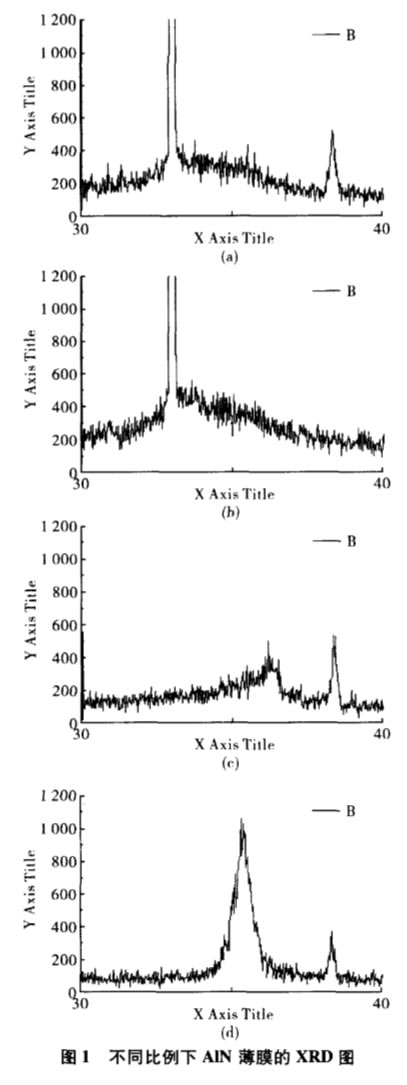
在实验中可同时观察到在N2气流量较小时,溅射靶面较光亮,反应溅射处于金属模式,无沉积物出现,N原子被从靶面溅射出的Al原子所消耗,靶面处于较清洁的金属状态。N2气流量在增大时,N2分子在气相反应和衬底表面的掩埋作用消耗后,尚有剩余,且在溅射气氛中维持较低分压,使靶面处于部分氮化状态,此时靶面有一薄层松散沉积物生成,围绕靶心呈环形分布。随着流量的增大,沉积物的颜色逐渐从深灰色过渡到黑色,同时靶面沉积物区域面积迅速增大,出现靶中毒现象。AkhmatorV等也观察到了类似的靶面中毒现象,并推断此沉积物就是氮化铝(AlN)。
2.2 金刚石上氮化铝薄膜x射线衍射结果分析
利用磁控溅射制备薄膜,工作气压是一个重要的实验参数。工作气压过低,气体分子数密度过小会影响辉光放电,导致灭辉。工作气压过高,气体分子平均碰撞几率增大,溅射粒子的动能降低,靶材的散射损失也增大。
同时,工作气压是影响AlN薄膜取向生长的一个重要因素。图2为不同工作气压条件下在金刚石上制备的AlN薄膜的XRD图。本实验中衬底温度为300℃,Ar:N2=8:12,溅射功率100W,沉积时间180min。从图2(a)可看出,当工作气压为0.3Pa时,在2θ=36.0℃存在一个衍射峰,与纤锌矿结构AlN的(002)峰对应。表明在较低的工作气压下,AlN薄膜为(002)的择优取向。从0.6Pa开始并随工作气压的提高,(002)峰的衍射强度逐渐减弱;与此同时,在33.2℃出现了与纤锌矿结构AlN的(100)峰对应的衍射峰如图2(c),且其强度随工作气压的提高而增强。增大工作气压使溅射粒子的平均自由程减小,溅射粒子与气体离子碰撞几率加大,到达基片的粒子能量也减小。从热力学角度来讲,沉积粒子能量较小使得在基片上的形核密度变小。假设开始沉积的原子核取向是随机的,形核密度低可以使C轴平行于基片即(100)取向的晶粒沿着基片生长很长一段距离,而(002)取向的晶粒垂直基片生长,会因为突出的晶界有较大的界面能而消失,所以(100)取向的晶粒会占主导。当形核密度较大时,(100)取向的晶粒生长时会碰到其它的晶粒而阻止其生长,这样(002)取向的晶粒会占主导。

3、结论
采用磁控反应溅射系统制备氮化铝膜。当溅射气压较低时,薄膜呈(002)择优取向。氮气比例的增加有利于AIN(002)取向的生长。相反氮气比例降低时,薄膜呈(100)择优取向。
作者:卢 勤 ,李化鹏 ,陈希明
声明:本站部分图片、文章来源于网络,版权归原作者所有,如有侵权,请点击这里联系本站删除。
| 返回列表 | 分享给朋友: |








 京公网安备 11010502053715号
京公网安备 11010502053715号